快科技12月8日消息,博通发布了全新打造的3.5D XDSiP封装平台,专门面向超高性能的AI、HPC处理器,最高支持6000平方毫米的芯片面积。
这相当于大约八颗NVIDIA Blackwell架构的下一代旗舰芯片GB202,后者面积为744平方毫米。
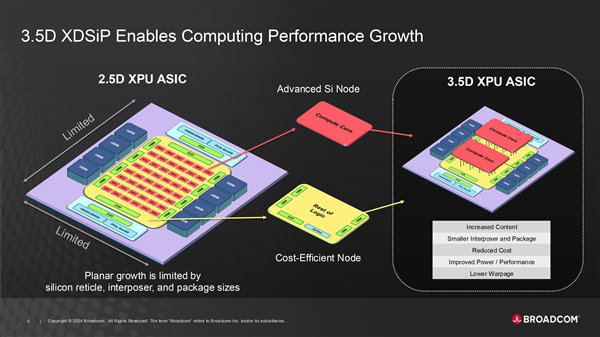
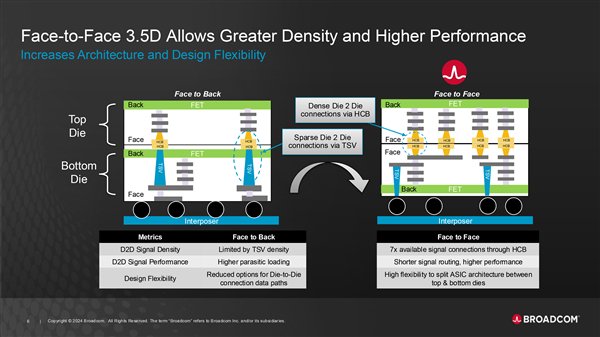

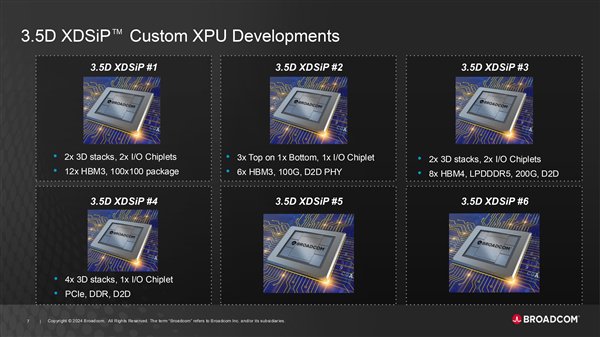

🚀博通发布了全新3.5D XDSiP封装平台,专为超高性能AI、HPC处理器设计,最高支持6000平方毫米芯片面积,约等于八颗NVIDIA下一代旗舰芯片GB202。
⚙️该平台采用台积电CoWoS-L封装技术,融合2.5D集成和3D封装,可将3D堆栈芯片、网络与I/O芯粒、HBM内存整合为系统级封装(SiP),最大中介层面积达4719平方毫米,可封装最多12颗HBM3或HBM4内存。
💡为了达成最高性能,博通建议分别设计不同的计算芯粒,采用F2F面对面方法,借助混合铜键合(HCB)将不同芯粒堆叠,无需TSV硅通孔,可使信号连接数量增加约7倍,互连功耗降低最多90%,最大化降低延迟。
🤝博通计划利用3.5D XDSiP为Google、Meta、OpenAI等设计定制化AI/HPC处理器、ASIC芯片,提供包括HBM PHY、PCIe、GbE、全套芯粒方案、硅光子技术等丰富的IP支持。
⏳博通预计首款基于3.5D XDSiP封装平台的产品将在2026年推出。
快科技12月8日消息,博通发布了全新打造的3.5D XDSiP封装平台,专门面向超高性能的AI、HPC处理器,最高支持6000平方毫米的芯片面积。
这相当于大约八颗NVIDIA Blackwell架构的下一代旗舰芯片GB202,后者面积为744平方毫米。
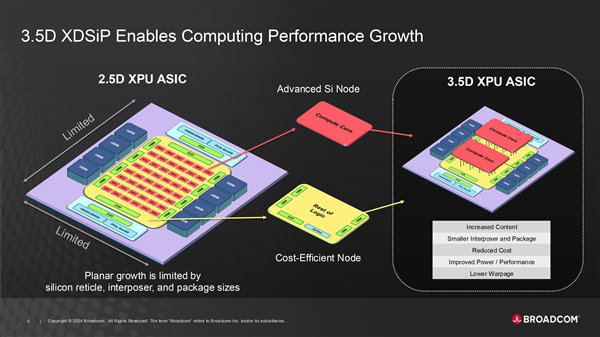
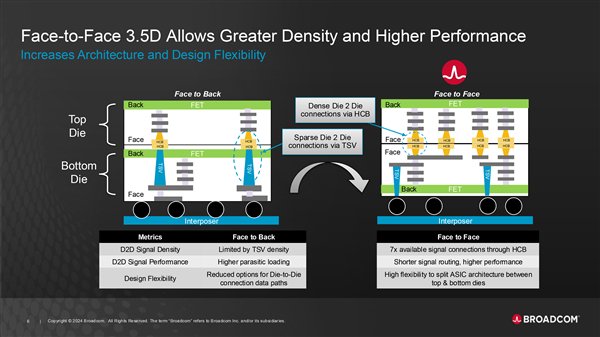

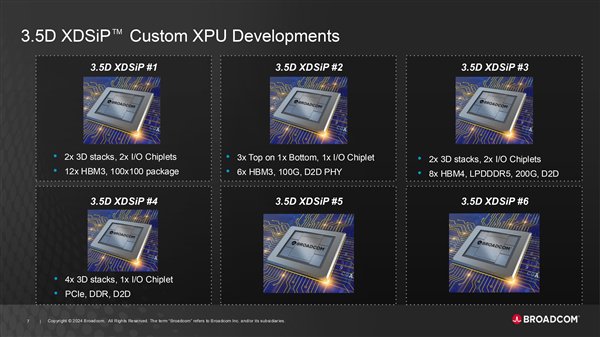
AI辅助创作,多种专业模板,深度分析,高质量内容生成。从观点提取到深度思考,FishAI为您提供全方位的创作支持。新版本引入自定义参数,让您的创作更加个性化和精准。

鱼阅,AI 时代的下一个智能信息助手,助你摆脱信息焦虑