摩尔定律越来越靠近终点
某电公布的半导体工艺路线图:
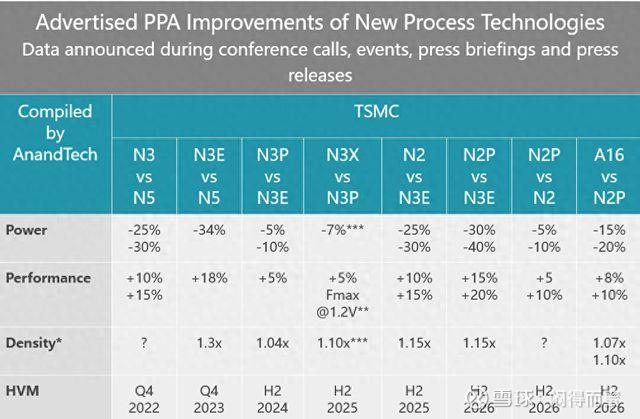
但跟10年前严格遵循摩尔定律(性能翻倍、功耗减半、成本减半)完全不同。现在每个代际之间,好比拧麻花,一点点挤,提升空间10%~20%之间。半导体工艺越来越接近极限。
3D封装兴起
AI发明了Scaling-law,每四个月算力需求提升一倍。scaling-law和moore-law之间的剪刀差越来越大,怎么办?
3D封装来撑场面,俗称摊大饼。

在2030年,半导体工艺最大只能做出2000亿晶体管的裸die,但是,某电通过3D封装实现10000亿们晶体管的芯片。
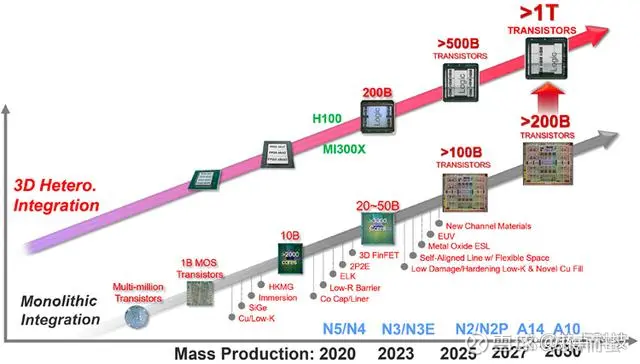
中芯国际的机会
3D封装是延续摩尔定律的一个可行的办法。但也有前提。比如对手用4nm工艺,4颗裸die合封做出一颗2000亿门的芯片,等效到中芯国际,则至少需要8颗裸die。即使用3D封装,也会导致封装扩大很多,带来Die与Die的互联线从1cm,延长到10cm以上,信号线的带宽低、功耗大、延迟大。
仅有3D封装,无法实现弯道超车,还差临门一脚。
问题的核心在:Die与Die的互联。只要解决互联,就妥了。
有办法吗? 有。 真有: 硅光Optical I/O
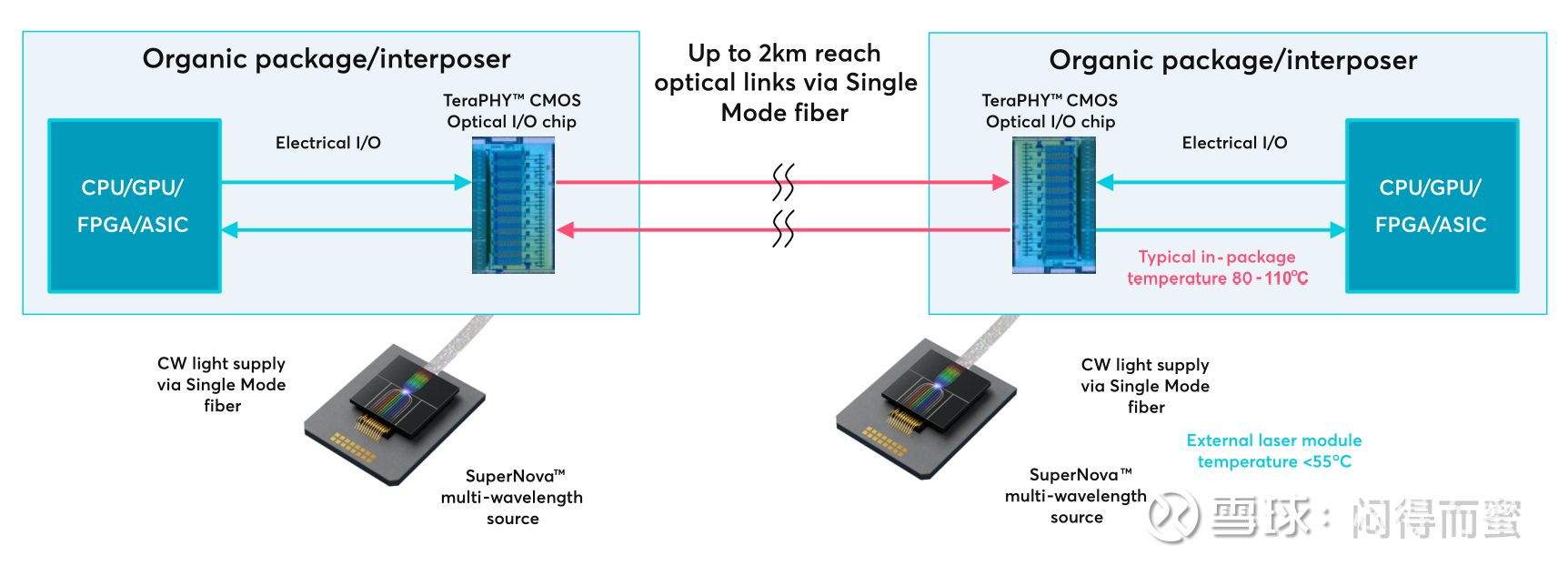
这个技术,牛笔的地方在于,距离可以到2km,且功耗极低,跟PCB上Die-Die互联居然相当。(NVlink-C2C就是伟哥的PCB内GPU与GPU接口,OIO的功耗跟它接近)

通过2.5D 封装做成chiplet,容易集成:

故事很好听,自主可控搞定了吗?
1、我们国家,光强电弱,硅光产业,学术、设计、工厂,大部分比美国还强。
2、硅光只需要45nm 的SOI CMOS就够了。我们已经解决了28nm工艺的全部自主可控,所以工艺不存在问题。
3、硅光的难点在封装和测试,80%的CAPEX都投资在这里,里面有大量的know-how。放到三年前,这确实不好说。不过随着罗博特科即将完成重组德国的斐控,一步登天,我们国家掌握了最先进的硅光整线核心设备。
万事就绪,等着寒武纪修改架构方案了,两年后,看到寒武纪推出类似下面的AI算力方案,大家不要觉得奇怪:
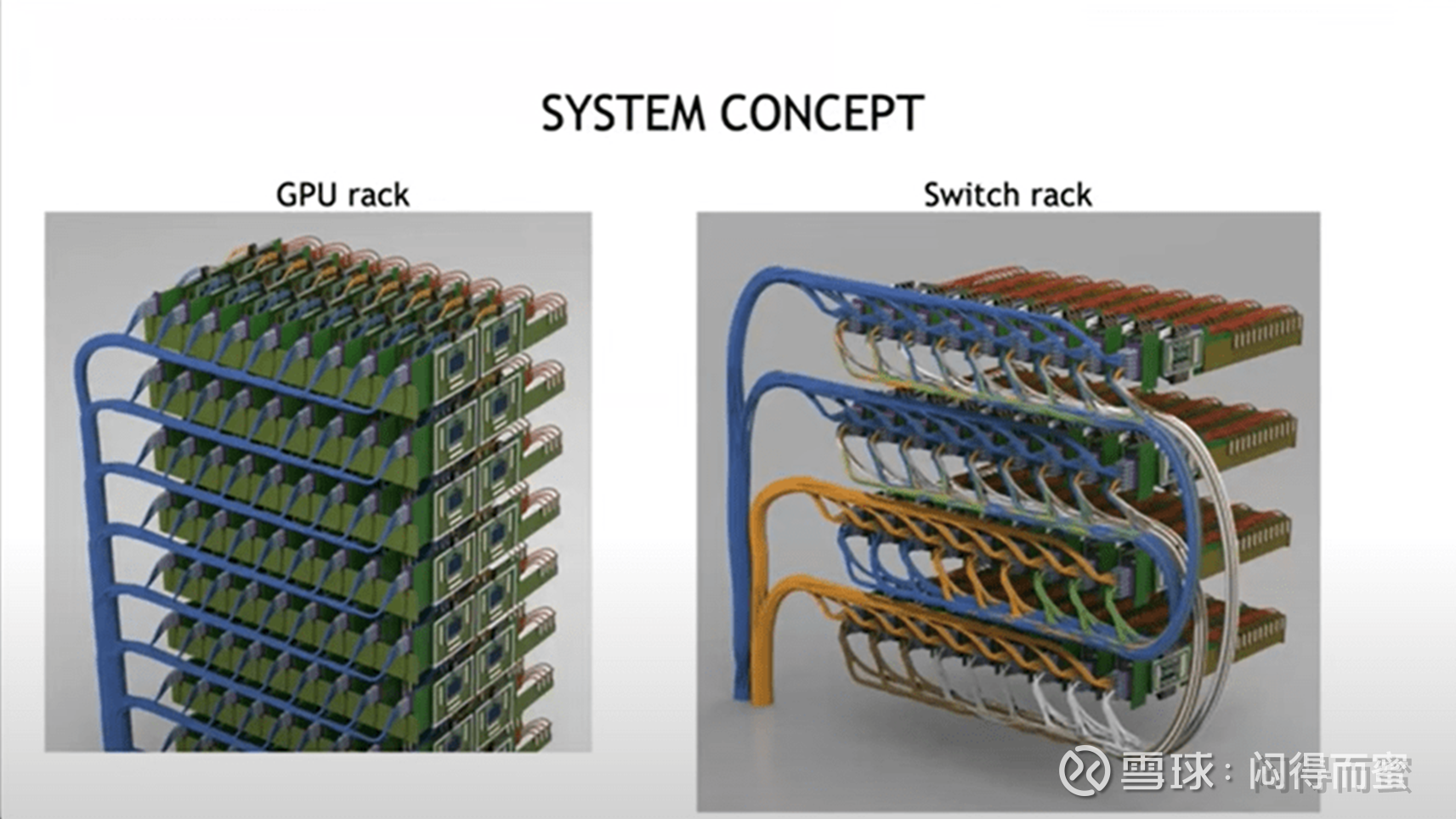
GPU和Switch,被池化,分割成一个个小单元,各自组成GPU机柜、Switch机柜,甚至将来HBM内存颗粒,都做成HBM机柜,然后通过高速光纤连接起来,你想哪个部件多配一点,就多配一点,pay as you grow。完全不需要像英伟达那样,被他绑得死死的。
总结
我们国家最大的优势是,地大物博:摊大饼的条件完全满足。
用西北的新能源发电,在漠北建大规模的AI集群,用硅光,将他们连接起来。
此计若成,两万亿市值的中芯国际、五千亿市值的寒武纪,梦想成真?
$中芯国际(SH688981)$ $寒武纪-U(SH688256)$ $半导体ETF(SH512480)$
本话题在雪球有61条讨论,点击查看。
雪球是一个投资者的社交网络,聪明的投资者都在这里。
点击下载雪球手机客户端 http://xueqiu.com/xz]]>

